发布日期:2022-04-17 点击率:19
SRM 640f 硅粉(X射线衍射)材料来源:硅得自 Siltronic AG (Munich, Germany)。粉碎由 Hosokawa Micron Powder Systems (Summit, NJ) 进行。
认证方法:认证是使用来自 NIST 构建的衍射仪 [3] 的数据进行的,并使用 Pawley 方法 [5] 通过基本参数方法 (FPA) [4] 进行分析。这些分析用于验证同质性并验证晶格参数。经认证的晶格参数值与国际单位制 (SI) [6] 定义的基本长度单位的联系是使用 Cu Kα 辐射的发射光谱作为构建衍射剖面的基础而建立的。使用 FPA,衍射剖面被建模为描述波长光谱的函数的卷积,衍射光学的贡献,以及微观结构特征产生的样品贡献。分析来自发散光束仪器的数据需要了解衍射角和有效的源-样品-检测器距离。因此,FPA 分析中包含了两个额外的模型,以说明样本高度和衰减的影响。基于对测量误差性质的了解,在通过统计分析分配的 A 类不确定性和 B 类不确定性的背景下分析认证数据,从而为认证值建立稳健的不确定性。
在粉碎之前验证单晶硅材料的均匀性。这些测量是在 NIST 晶格比较设备 [7] 上使用从所提供材料中提取的 11 个晶体样品进行的。共进行了 32 次晶格比较测量,覆盖了纵向和径向晶锭方向。这些测量表明的相对晶格变化为 ± 4.8 × 10-8(95 % 置信水平),表明材料足够均匀,可用作粉末线位置标准品,以在晶格参数方面进行认证 [8]。
认证程序:SRM 640f 硅粉(X射线衍射)在装瓶操作期间,以分层随机方式从单位数量中选择十个 SRM 640f 单位。从 10 瓶中的每瓶制备的 2 个样品中记录认证数据,总共 20 个样品。用于认证测量的衍射仪的光学布局是布拉格-布伦塔诺几何形状的传统发散光束衍射仪,配备 Johansson 入射光束单色仪 (IBM)、样品旋转器和位置敏感检测器 (PSD)。 1.5 kW 精细聚焦几何形状的铜管以 1.2 kW 的功率运行。可变发散入射狭缝设置为 0.9°。
一个 1.5° 的索勒狭缝位于 PSD 窗口的前面以限制轴向发散,入射光束中没有使用索勒狭缝。从 25° 到 140° 的 2θ 范围收集数据;扫描时间约为 2.5 小时。 PSD 以“拍照”模式进行扫描,其中记录了 PSD 窗口全长的数据。窗口长度为 14.4 mm,分为 192 个 75 μm 的条带,测角仪半径为 217 mm,这对应于窗口尺寸 3.8 °2θ,角分辨率为 0.02 °2θ。使用了在 3.8° 的情况下的粗步骤和在 0.02 °2θ 的情况下的细步骤的组合;这允许以高分辨率及时收集数据。后数据收集处理允许使用 Tanθ 缩放 PSD 窗口长度。结果是一种有效地具有可变停留时间的图案,从而改善了高角度反射的统计数据,而不会降低分辨率 [9]。该机器配备了位于样品上方的自动防散射狭缝,以防止来自事件的空气散射进入 PSD 并导致低角度背景水平。它在样品上方的高度变化为 αR / (2 cosθ),其中 α 是入射光束的全赤道发散角。该机器位于温度受控的实验室空间内,标称短程温度控制为 ± 0.1 °K。使用两个 10 kΩ 热敏电阻和一个 Hart/Fluke BlackStack 系统监测温度,该系统在 NIST 温度校准设施 [10] 校准到 ±0.002 °C。在记录任何认证数据之前,源在操作条件下至少平衡一小时。机器的性能通过使用 SRM 660c 线位置和线形标准进行粉末衍射 [11] 和 SRM 676a 氧化铝粉末进行 X 射线衍射定量分析 [12] 使用 Cline 等人讨论的程序进行了鉴定。 [3]。
数据分析:认证数据使用 FPA 方法和 TOPAS [13] 中实施的 Pawley 改进进行分析。门登霍尔等人。 [14] 验证了 TOPAS 按照已发布的 FPA 模型运行。该分析使用了 Mendenhall 等人表征的 Cu Kα 发射光谱的能量。 [15]。 Johansson IBM 的光学系统使用来自单色仪的动态散射以及粉末样品根据 2 晶体单色仪的光学系统进行建模。由此产生的“带通”模型提供了一个“窗口”功能,它可以调节来自我们的 X 射线管的原生铜发射线的强度,有效地切断原生线的洛伦兹尾部,与尾部的形状提供良好的一致性的衍射峰。它还在 FPA 发射模型中添加了一个色散项,增加了建模线的宽度,进一步提高了对观测值的拟合 [16]。与带通模型相关的参数以及 IPF 的其他参数、“全”轴向发散模型 [17] 的入射狭缝角度和索勒狭缝角度使用来自 SRM 660c 的扫描进行了细化。然后将它们固定在 SRM 660c 值以进行 SRM 604f 分析。其他细化参数包括比例因子、用于背景建模的切比雪夫多项式项、晶格参数、样本位移和衰减项以及洛伦兹尺寸展宽项。使用 Sch?del 和 B?nsch [18] 中发现的 CTE 值将细化的晶格参数调整为 22.5 °C 时的值。
数据的统计分析表明,测量的平均值为 0.543 114 4 nm,k = 2 A 类扩展不确定度为 0.000 000 54 nm。但是,由于系统误差导致的 B 类不确定性必须纳入认证晶格参数的不确定性范围内。考虑到认证中使用的数据趋势,会导致分配 B 类不确定性和值,如第 1 页所述。
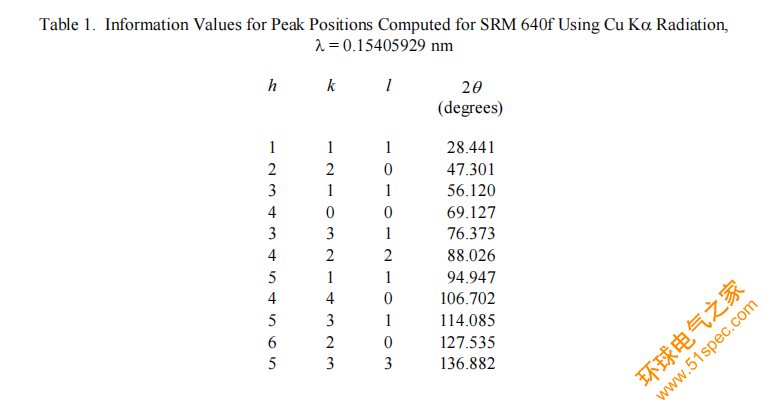
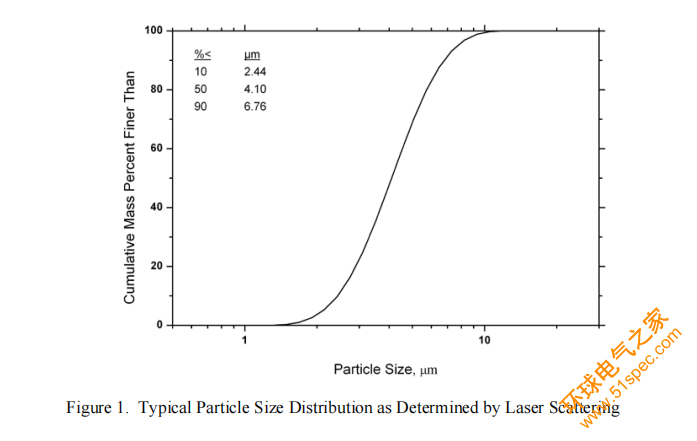
篇幅有限,需要了解更多产品信息,请联系我们!
下一篇: PLC、DCS、FCS三大控
上一篇: 环境监测用LB-TC1002